Problema 384162: Altera de informações sobre o pacote de dispositivos, versão 16.6
O pino A1 está ausente para alguns dos pacotes de rede de esfera fina (FBGA) de 484 pinos - Wire Bond - A:2.40 e será corrigido na próxima revisão. O pino A1 deve ser mostrado, mas está faltando apenas no desenho mecânico.
Problema 10006628: Altera de informações sobre o pacote de dispositivos, versão 16.1
há uma atualização sobre o valor de resistência térmica para dispositivos EP3C16U484, EP3C40U484 e EP3C40F780 conformeTabela abaixo:
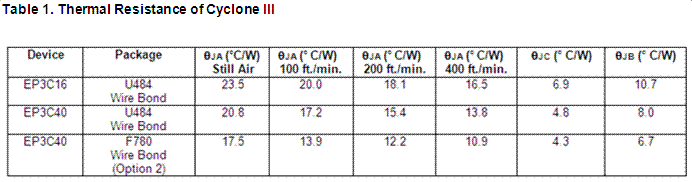
Ficha técnica 10006284, Altera do pacote de dispositivos versão 16.1
A nota de rodapé (1) para a Tabela 13. Cyclone III dispositivos da Altera de informações do pacote de dispositivos está incorreta. A seguir, a nota de rodapé correta:
"O pacote E144 tem uma base exposta na parte inferior do pacote. Este bloco de terra é usado para conectividade elétrica, não para fins térmicos. Ele deve estar conectado ao plano terrestre do PCB."
Ficha técnica 10006277, Altera do pacote de dispositivos versão 16.1
Saiba que há uma atualização sobre o valor de resistência térmica para EP3CLS100 e EP3CLS200 conforme Tabela 1 abaixo:
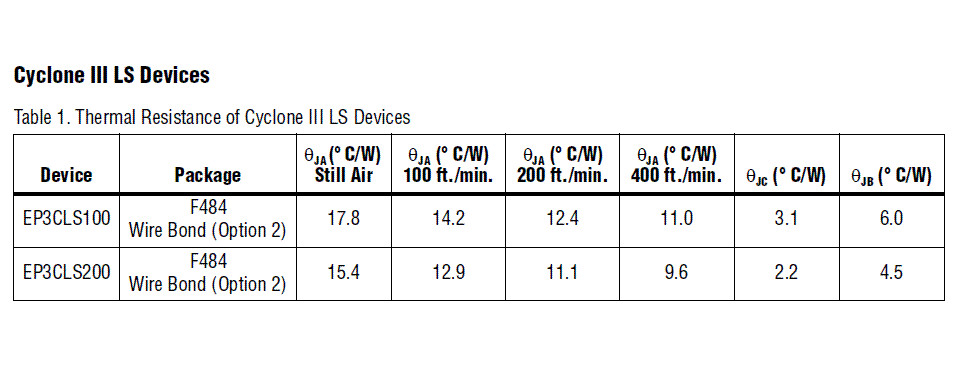
Ficha técnica 10006284, Altera do pacote de dispositivos versão 16.1
A nota do pacote E144 na tabela 13 foi alterada nesta edição da ficha técnica da embalagem e está incorreta. Não há blocos VCC expostos sob este dispositivo, mas há um bloco de terra exposto. Os desenhos do pacote estão corretos.
Ficha técnica 10006283, Altera do pacote de dispositivos versão 16.1
A Tabela 4 afirma incorretamente que o EP4SGX290 no pacote FF35 é uma Tampa de peça única: FBGA, Flip Chip, Opção 2 que aponta para as páginas 283-284 da ficha técnica. Você deve usar o contorno do pacote nas páginas 303-304 para este pacote de dispositivo.
Ficha técnica 10006120,Altera do pacote de dispositivos versão 16.1
A visão superior do contorno do pacote de 1152 pinos FineLine Ball-Grid Array (FBGA) - Flip Chip - Tampa de peça única -EP4SGX360 está incorreta. A visualização superior correta deve ser como a Figura 1 (abaixo).

Ficha técnica 10006119, Altera do pacote de dispositivos versão 16.1
O POD de 256 pinos FineLine Ball-Grid Array (FBGA), Opção 2 – Wire Bond é aplicável apenas aos pacotes F256 de produtos Cyclone II, Cyclone III e Cyclone IV.
O POD de 256 pinos FineLine Ball-Grid Array (FBGA), Opção 1 – Wire Bond é aplicável a F256 de todos os produtos, exceto os produtos Cyclone II, Cyclone III e Cyclone IV, que é montado nos contornos do pacote opção 2.
A Altera de informações sobre o pacote de dispositivos será atualizada para mostrar o contorno correto do pacote para o FBGA (Wire Bond) de 256 pinos fineline ball-grid array.
Ficha técnica 10006122, Altera do pacote de dispositivos versão 16.1
O dispositivo EP4SE230 de 780 pinos deve ter a descrição do pacote como Tampa do canal: FBGA, Flip Chip, Opção 1, não é tampa de peça dupla: FBGA, Flip Chip, Opção 1.
A Altera de informações sobre o pacote de dispositivos será atualizada para mostrar a opção correta do pacote para o dispositivo EP4SE230 de 780 pinos.
Ficha técnica 10006121, Altera do pacote de dispositivos versão 16.1
A visão superior do contorno do pacote de 1517 pinos FineLine Ball-Grid Array (FBGA) - Flip Chip - Dual-Piece Lid - EP4SGX180 está incorreta. A visualização superior correta deve ser como a Figura 1 (abaixo).

Ficha técnica de 10005898, Altera do pacote de dispositivos versão 16.0
Se você estiver usando um dispositivo EP4SE820, ele indicará que a opção de pacote a que você deve se referir é a Opção 4. Isso está incorreto e você deve estar se referindo à Opção 3. Consulte a ficha técnica Altera do pacote de dispositivos (PDF) versão 16.1 para esclarecimento deste problema.